行動運算當道 Invensas引領先進封裝發展
前言:
專訪Invensas 公司Mobile Programs 副總裁Wael Zohni

Invensas 的 Bond Via Array™ (“BVA™”) 技術是一種高性能的層疊封裝 (PoP),它使用常規銲線技術代替矽穿孔 (TSV) 技術,為行動計算和低功耗計算實現了超高的 I/O 記憶體邏輯介面。
Q1. 請說一下行動運算的市場趨勢
行動計算繼續受到更小、更快、更便宜這樣的魔咒驅策。簡而言之,當討論行動市場的發展趨勢時,尺寸是永遠不會跑偏的話題。考慮到消費者對更薄、更輕手機的需求,縮小外形仍然是一個驅動因素。
行動計算繼續受到更小、更快、更便宜這樣的魔咒驅策。簡而言之,當討論行動市場的發展趨勢時,尺寸是永遠不會跑偏的話題。考慮到消費者對更薄、更輕手機的需求,縮小外形仍然是一個驅動因素。
同樣重要的是,市場現在還要求裝置運行的功率更低。我們的目標是實現更長的電池壽命,並提供快速充電功能。事實上,正在發展多核處理器來提升性能,同時提供高效電源管理工具。
同時,提升性能的要求體現於多個層面,行動裝置必須增加連接性,支援更多連線。這包括諸如 4G LTE、TV、GPS、NFC 和感應器等細目。另一個需求是對多媒體的支援;因為行動裝置正在發展成為真正無處不在的新功能,例如 HDR 錄影、連拍模式照相機、照片編輯、身歷聲輸出、HDMI 和 TV 輸出等等,所有這些都需要考量。各種新興的特殊功能,例如防水、防塵、安全交易、指紋識別/保密功能,以及攜帶式投影機等,將繼續增加對性能的要求,並推動創新。
Q2. 現今的行動設備,在先進封裝方面,遇到何種挑戰?
如果我們看一下今天的行動裝置系列產品,它龐大而多樣,涵蓋了筆記型電腦、智慧型手機、平板電腦、功能型手機,甚至可穿戴式電子產品。所有這些裝置都具有相似屬性 — 通常產品生命週期更短(2 年),性能要求各異,但全都要求高可靠性,尤其是在機械(摔落測試)和熱性能(散熱)方面。
如果我們看一下今天的行動裝置系列產品,它龐大而多樣,涵蓋了筆記型電腦、智慧型手機、平板電腦、功能型手機,甚至可穿戴式電子產品。所有這些裝置都具有相似屬性 — 通常產品生命週期更短(2 年),性能要求各異,但全都要求高可靠性,尤其是在機械(摔落測試)和熱性能(散熱)方面。
因此,先進封裝需要提供一種解決方案,以滿足更高運行性能、更小外形,同時保持高可靠性、降低熱阻和更低成本的要求。這對設計師來說是一個巨大挑戰,並導致先進封裝產業發生了翻天覆地的變化。封裝顯然已成為一個為裝置增值的領域,並且對於實現消費者所要求的更高性能至關重要。
Q3. 目前POP所面對的困難/議題是什麼?
目前的層疊封裝 (PoP) 技術依賴於現有的 BGA 表面貼裝式 (SMT) 製程,其中銲球形成背面邏輯電路和正面記憶體元件之間的接點。這種常規 BGA 表面貼裝製程本身固有物理隔離問題,因此縮小連接間距需要減小銲球直徑。然而,減小銲球直徑將導致適應基本邏輯裝置所需的隔離高度降低。其結果是,目前的 PoP 元件僅限於大約 0.5mm 的垂直連線,其變化幅度不大,例如 through-mold-via (TMV) 提供遞減至大約 0.4mm 間距。這限制了處理器和記憶體之間的連線數量,典型的 14x14mm 封裝限制在大約 300 個連線,這對頻寬和裝置性能均有顯著影響。
目前的層疊封裝 (PoP) 技術依賴於現有的 BGA 表面貼裝式 (SMT) 製程,其中銲球形成背面邏輯電路和正面記憶體元件之間的接點。這種常規 BGA 表面貼裝製程本身固有物理隔離問題,因此縮小連接間距需要減小銲球直徑。然而,減小銲球直徑將導致適應基本邏輯裝置所需的隔離高度降低。其結果是,目前的 PoP 元件僅限於大約 0.5mm 的垂直連線,其變化幅度不大,例如 through-mold-via (TMV) 提供遞減至大約 0.4mm 間距。這限制了處理器和記憶體之間的連線數量,典型的 14x14mm 封裝限制在大約 300 個連線,這對頻寬和裝置性能均有顯著影響。
利用現有的銲線技術,BVA™ PoP 能夠縮小連線間距至少 0.2mm,這使 PoP 配置成為可能,從而可在給定的封裝外形內容納 3 倍的垂直連線數量,不僅增加了頻寬,而且還能實現最高性能。
Q4. BVA技術的特點?能為行動運算帶來何種好處?
Invensas 的 ™ (“BVA™”) 技術是一種高性能的層疊封裝 (PoP),它使用常規銲線技術代替矽穿孔 (TSV) 技術,為行動計算和低功耗計算實現了超高的 I/O 記憶體邏輯介面。
Invensas 的 ™ (“BVA™”) 技術是一種高性能的層疊封裝 (PoP),它使用常規銲線技術代替矽穿孔 (TSV) 技術,為行動計算和低功耗計算實現了超高的 I/O 記憶體邏輯介面。
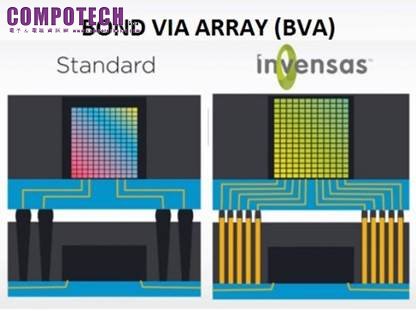
BVA 技術為行動電話和平板電腦提供了最高頻寬的封裝解決方案。該產品在 0.24 mm 間距擁有 1000 多個互相連線,可在 14mm x 14mm 封裝尺寸內的多核 CPU/GPU 處理器和 DDR3/DDR4/Wide IO 記憶體之間實現高達 512bit 的記憶體匯流排。採用 800 MHz 的記憶體裝置,在處理器和記憶體封裝之間能夠實現前所未有的 100 GB/s 頻寬。這一性能是使用現有材料和基礎架構,以低成本透過先進封裝實現的。BVA 的優勢包括:
•更高性能:在背面邏輯封裝和正面記憶體封裝之間的超高 IO (四通道以上,高達 512bit 頻寬)能夠提供高達 100 GB/s 以上的頻寬
•PoP 方法:邏輯電路和記憶體獨立採購、封裝和測試,可實現高良率和供應鏈靈活性
•記憶體相容性:使用目前的 LPDDR2 和 LPDDR3,同時可擴展至更寬的 IO 記憶體裝置
•封裝可靠性高,且成本低:利用既有組裝設備、製程和材料
•PoP 方法:邏輯電路和記憶體獨立採購、封裝和測試,可實現高良率和供應鏈靈活性
•記憶體相容性:使用目前的 LPDDR2 和 LPDDR3,同時可擴展至更寬的 IO 記憶體裝置
•封裝可靠性高,且成本低:利用既有組裝設備、製程和材料
Q5. TSV會取代BVA嗎?原因為何?
TSV 在不久的將來取代 BVA 是不可能的,因為 BVA 擴展了具有成本效益的 PoP 技術,以滿足對記憶體處理器頻寬的未來需求,例如由寬 IO 標準規定的那些頻寬。作為一種技術擴展,BVA 彌合了今天的 PoP 能力與未來 TSV 產品預期性能之間的巨大差距。
TSV 在不久的將來取代 BVA 是不可能的,因為 BVA 擴展了具有成本效益的 PoP 技術,以滿足對記憶體處理器頻寬的未來需求,例如由寬 IO 標準規定的那些頻寬。作為一種技術擴展,BVA 彌合了今天的 PoP 能力與未來 TSV 產品預期性能之間的巨大差距。
問題是,TSV 技術及其實施在基礎架構、製造業和成本方面繼續面臨巨大挑戰。目前尚不清楚解決這些挑戰尚需多久,因此,TSV 產品目前僅限於高度專業化應用。看來,在 TSV 成為行動裝置中的現成主流技術之前,還需要投入大量的時間和精力。在 TSV 具備市場普及條件之前,BVA 無疑能夠提供諸如寬 IO 等次世代行動裝置所要求的性能,同時還能降低成本。